발열로 인한 성능 저하 억제…지속 성능 개선
[서울=뉴스핌] 서영욱 기자 = 삼성전자가 고성능 연산과 온디바이스 인공지능(AI) 확대로 커진 모바일 애플리케이션 프로세서(AP) 발열 문제를 해결하기 위해 패키지 구조를 바꾼 열 방출 개선 방안을 내놨다.
스마트폰이 점점 얇아지면서 제한된 공간에서 전력 소모와 발열이 함께 늘어, 단순한 성능 향상만으로는 지속 성능을 유지하기 어렵다는 판단이다.
삼성전자는 22일 모바일 AP 칩 상단에 HPB(Heat Path Block)를 배치해 열 저항을 낮추는 패키지 구조를 개발했다고 밝혔다.
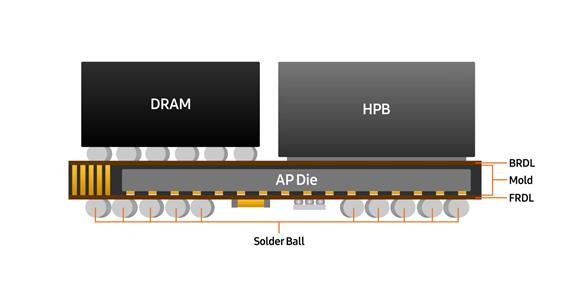
HPB는 열이 집중되는 AP 상부에서 발생한 열을 외부 방열 부품으로 빠르게 전달하도록 설계된 열 전달 블록이다. 삼성은 업계 최초로 FoWLP(Fan-out Wafer Level Packaging)에 HPB를 적용한 사례라고 설명했다.
기존 플래그십 AP는 AP 위에 D램을 적층하는 PoP(Package on Package) 구조가 주로 쓰였다. 그러나 패키지가 얇아질수록 AP 다이 두께도 줄어 열 확산 경로가 제한되고, 열이 효과적으로 빠져나가지 못해 칩 온도가 빠르게 상승하는 문제가 나타난다.
특히 PoP 구조에서는 AP 상부에 D램 패키지가 위치해 히트 스프레더나 베이퍼 챔버 등 방열 부품과의 직접적인 열 전달이 어렵다는 한계가 있다.
삼성은 이 같은 병목을 줄이기 위해 D램 패키지를 발열 영역과 겹치지 않도록 재배치하고, 발열원 바로 위에 HPB를 배치하는 방식으로 열 방출 구조를 재설계했다.
HPB는 구리 기반 금속 소재로 제작돼, 기판 유전체층이나 DAF, EMC 등 폴리머 기반 소재보다 높은 열전도 성능을 확보했다.
삼성전자는 엑시노스 2600에 HPB를 적용했으며, 고부하 환경에서 칩 온도 상승을 억제해 지속 성능 측면에서 유리한 조건을 마련할 수 있다고 강조했다.
삼성전자는 HPB 적용 상태에서도 구조적 안정성을 확보하기 위해 열전도율과 접착 신뢰성을 고려한 새로운 TIM(Thermal Interface Material)도 함께 적용했다.
개발 과정에서는 D램 패키지 면적을 절반 수준으로 줄이고 패키지 높이와 두께를 최적화했다. 비대칭 D램 배치에 따라 AP-D램 인터페이스 구조도 새로 설계했다. 삼성전자는 시뮬레이션과 반복 실험, 유관 부서 협업을 통해 목표 성능을 검증했다고 덧붙였다.
삼성전자는 "모바일 프로세서의 성능 요구가 커질수록 패키지 수준의 열 저항 설계가 성능을 안정적으로 끌어올리는 핵심 요소가 된다"며 "HPB 기반 패키지 아키텍처를 바탕으로 차세대 모바일 플랫폼에서도 성능과 열 안정성, 공간 효율을 함께 만족시키는 기술 고도화를 이어가겠다"고 밝혔다.
syu@newspim.com























